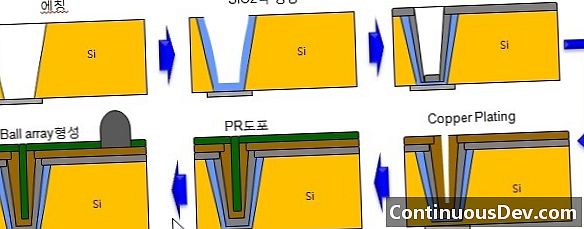
Obsah
- Definice - Co znamená Via-Silicon Via (TSV)?
- Úvod do Microsoft Azure a Microsoft Cloud | V této příručce se dozvíte, o čem cloud computing je a jak vám může Microsoft Azure pomoci migrovat a řídit podnikání z cloudu.
- Techopedia vysvětluje Via-Silicon Via (TSV)
Definice - Co znamená Via-Silicon Via (TSV)?
Průchozí křemík přes (TSV) je typ spoje přes (vertikální propojení) používaný v mikročipovém inženýrství a výrobě, který zcela prochází křemíkovou zápustkou nebo oplatkou, aby bylo možné skládat křemíkové kostky. TSV je důležitou součástí pro vytváření 3-D balíčků a 3-D integrovaných obvodů. Tento typ připojení funguje lépe než jeho alternativy, jako je balíček-on-package, protože jeho hustota je vyšší a jeho připojení kratší.Úvod do Microsoft Azure a Microsoft Cloud | V této příručce se dozvíte, o čem cloud computing je a jak vám může Microsoft Azure pomoci migrovat a řídit podnikání z cloudu.
Techopedia vysvětluje Via-Silicon Via (TSV)
Průchod křemíkem přes (TSV) se používá při vytváření trojrozměrných balíčků, které obsahují více než jeden integrovaný obvod (IC), který je svisle stohován způsobem, který zabírá méně místa a přitom stále umožňuje větší konektivitu. Před TSV měly 3-D balíčky naskládané integrované obvody IC na okrajích, což zvětšilo délku a šířku a obvykle vyžadovalo dodatečnou vrstvu „meziproduktů“ mezi IC, což vedlo k mnohem většímu balení. TSV odstraňuje potřebu zapojení hran a interposerů, což má za následek menší a plošší balíček.Trojrozměrné integrované obvody jsou svisle naskládané čipy podobné balíčku 3-D, ale fungují jako jedna jednotka, což jim umožňuje zabalit více funkcí do relativně malé patky. TSV to dále zvyšuje tím, že poskytuje krátké vysokorychlostní spojení mezi různými vrstvami.